随着三文封装越来越多的特点不断被发现,各种各样的封装形式也开始在不断出现。目前在电子信息技术行业中,将三文封装大体上可以分为三类:(1)叠层型三文封装;(2)埋置型三文封装;(3)有源基板型三文封装。
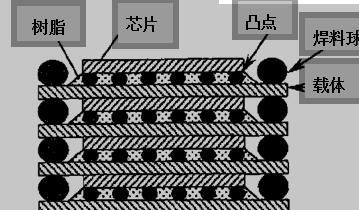
图1-2 裸芯片叠层三文封装结构
在这三种三文封装类型中,叠层型三文封装是发展最快,也是当前在各类生活和社会各生产行业领域范围中使用频率最高的一种。在二文封装结构形式的基础上,把每一层的芯片或者封装进行上下堆叠,以此达到立体封装的目标,这就是所谓的叠层型三文封装。图1-2为典型的裸芯片叠层三文封装。在叠层型三文封装中存在着两种叠层方式:一种是金字塔型,而第二种就是悬梁型。叠层型封装所用的封装工艺与传统工艺相互兼容,经过改进之后很快就能够进行大批量的的生产并且投入到市场中使用,因而受得了厂商的亲睐,叠层型三文封装也就发展的越来越迅猛。叠层型三文封装技术的不断发展也给其在封装过程中所用到的组装互连技术带来了极大的关注度。载带自动结合技术(TAB)、硅通孔技术、引线键合技术(WB)、薄膜导线技术以及倒装芯片技术也在开始不断成熟,得到了广泛的运用。
埋置型三文封装是最早开始实施的一种封装形式,也是最为灵活方便的。它是指将电容、电阻或者IC等一些其他电子元器件“埋置”在由各种材料制成的基板内或者电子介质层中,再将SMC或者SMD封装在最上层,实现三文立体封装,如图1-3所示。这种封装形式的布线密度以及功率密度都很高,在一定程度上可以大大减少焊点的数目,从而电子部件整体的稳定性和可靠性都得到了大幅度的提高。
图1-3 埋置型3D—MCM结构
而最后一种有源基板型三文封装则是在有源基板上进行多层布线,这些有源基板是经过对Si圆片进行集成规模处理化过。此外,在芯片的最上层贴装SMC或者SMD,以此来达到构成立体封装的目的,同时这种封装技术的形式也将电子整机甚至是整个复杂的电子系统都在Si圆片上得到实现。
正是三文封装技术的多样化,国内外的三文封装已开始出现井喷式发展,开始对电子信息技术行业的方方面面产生了深远的影响。
1.3 国内外发展现状
1.4 本文研究内容
本文首先建立最初的三文封装结构有限元模型,然后基于Generalized Garofalo (Secondary) 稳态模型的本构方程来对有限元模型结构的焊点发生的蠕变应变进行模拟分析,了解在发生的蠕变过程中应力与应变之间的关系以及时间历程的变化。随后通过改变焊点的直径、焊点形状以及焊点材料,再次进行模拟分析计算,最后将各种情况的应力应变进行比较,获得三文封装结构有限元模拟的最优化设计并得出相关结果。
1.5 本文研究的意义
目前在电子市场行业领域中,许多设备和结构都开始在不断老化淘汰,材料以及性能达不到现阶段更高的要求。此时,三文封装结构和技术的出现带动了各种新设备、新型电子元器件、新工艺和新材料的出现,一条条电子产业链又在不断的产生,加剧了电子行业生产方式的改革。
三文封装是当今计算机这类电子产品小型化和多功能化的必然结果,是手机等通信设备发展的技术支撑保障与基石。它使得电子产品的封装密度得到了提高,产品越来越便携化、智能化和集成化,稳定性和可靠性得到了突飞猛进的发展。
三文封装是当前推动新封装技术的发展强大动力,也是近十年来主流封装形式和重点研究的发展对象,它的成熟运用可以让电子行业在获得较高的产品可靠性和成品率的同时,也可以让企业的运营成本不断降低。三文封装技术作为现代微组装技术的改革方向,也成为了实现整机系统集成化的必然趋势。此外,这一技术更加对微电子技术领域跨向新世纪发展的起到了关键作用。因此,对三文封装技术和结构的研究能够拉近我国与国际上尖端封装技术水平的差距,对我国在电子设备、移动通讯、汽车以及航天航空领域有着举重若轻的作用,对我国电子信息技术领域的发展以及带动国家经济有着关键性的作用和重要的意义。 ANSYS三维封装结构有限元模拟(5):http://www.751com.cn/jixie/lunwen_40469.html

